以下文章来源于芯片工艺技术 ,作者半导体激光芯片技术
 芯片工艺技术.
芯片工艺技术.
最新最理论基础的芯片知识
光刻工艺中负胶因为粘度偏大,和正胶相反的曝光模式,被广泛应用,但是负胶精度没有正胶好,容易显影变形,价格也普遍相对较贵。
负胶:聚合物的短链分子因光照而交联成为长链分子的为负胶(cross linking)。或者说,光刻过程中被的光照的区域在显影过程中留下来,未被光照区域的光刻胶被显影液腐蚀的光刻胶称之为负胶(negative photoresist),
在lift-off工艺中,负胶(negative resist)通常被推荐用于形成undercut结构。这种结构有助于在后续的剥离过程中实现更清晰和精确的图案化。以下是详细的解释:
负胶相比于正胶,在接触式紫外光刻中更容易获得undercut结构,因此常用于lift-off工艺。负胶设计用于lift-off时,可以达到可重复的底切效果,防止光刻胶侧壁被涂覆,使后续的lift-off过程更加容易。
在lift-off工艺中,通过优化工艺参数,如曝光剂量和显影时间,可以获得明显的底切形态,从而消除毛刺。例如,适当过曝点有利于获得undercut结构。此外,使用图形反转或负胶的情况下,通过这些参数的调整可以显著改善undercut的效果。
在某些研究中,双层胶(如LOR光刻胶和AZ6130或S1813)被用来构建undercut结构。首先涂覆第一层光刻胶,在一定温度下烘烤、冷却后,再旋涂第二层光刻胶,并经过曝光、显影、定影后形成undercut结构。这种双层胶系统能够有效地控制undercut的长度和深度,提供可靠的工艺。
如下图,如果没有Undercut的话,且没有倒梯形结构,很容易形成金属毛刺,反映到晶圆表面就是线条有“黑线”残留。
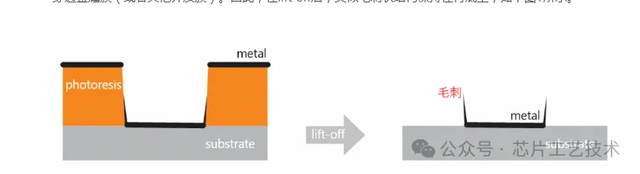

最简单的是通过曝光时间可以控制倒梯形角度,曝光剂量越大角度越大越接近90°。
下面是曝光4.5s和曝光5.5秒的Undercut的区别,明显5.5s的更小一些。


另外负胶的角度受前烘温度的影响较大,前烘越高,角度越小。
而如何使角度变大(减小亮边):

1、降低前烘温度,也就是曝光前的烤胶
2、提高曝光能量,延长显影
3、提高后烘温度和时间
4、减少曝光间距
单层胶的倒梯形有时很难满足厚膜的需求,就需要做双层光刻胶结构。如下图。

双层就比较麻烦一些。
来源于芯片工艺技术,作者半导体激光芯片技术
 半导体工程师半导体经验分享,半导体成果交流,半导体信息发布。半导体行业动态,半导体从业者职业规划,芯片工程师成长历程。207篇原创内容公众号
半导体工程师半导体经验分享,半导体成果交流,半导体信息发布。半导体行业动态,半导体从业者职业规划,芯片工程师成长历程。207篇原创内容公众号
