光刻工艺
光刻工艺的第一步是硅片清洗,采用机械或化学方法去除颗粒、污染物和其他缺陷。然后利用六甲基二硅氨烷(HMDS)处理硅片表面,提高光刻胶对硅片上氧化物(SiO2)的黏附性。之后,光刻胶被旋涂在硅片上,即旋转涂胶:在硅片上涂上一定量的光刻胶,通过旋转使光刻胶均匀地分布于硅片表面。通过调整涂胶机的转速和光刻胶溶液的黏度来控制光刻胶的厚度。
光刻工艺包含几个烘焙步骤。烘焙可以在热板或对流烘箱中进行,光刻胶较厚时有时也会采用微波烘焙。不同烘焙步骤的目的不同。预烘或前烘(PAB)发生在旋转涂胶之后、曝光之前。预烘的温度通常在90~100℃,以蒸发出用于旋转涂胶的光刻胶溶剂。后烘(PEB)有多个用途。对于大多数化学放大光刻胶,PEB的作用是启动脱保护反应。此外,化学物质的热扩散有利于提高关键尺寸CD的均性,增大显影后图形的侧壁陡度。需要注意的是,烘焙过程中的热处理还可以改变光刻胶材料的消光系数、折射率、扩散和力学性能等物理性能。先进工艺需要非常精准地控制不同时刻的温度,常用冷板进行温度控制。
曝光/烘焙后的光刻胶与液态显影液(如水性碱溶液)之间的化学反应即为显影。将硅片表面浸人显影液的方法有两种。第一种方法是旋覆浸没式显影,即将显影液滴到硅片/光刻胶表面,然后旋转硅片,类似于旋涂光刻胶的过程。第二利方法是将显影液喷洒在硅片上,边喷洒边旋转硅片。可以在几秒内除去曝光区域的正性光刻胶。显影30s或60s后,显影液与光刻胶之间的反应几乎就停止了。用超净水冲洗硅片并干燥,以确保不会继续显影。先进光刻工艺中的光刻胶工艺在涂胶显影机上进行。涂胶显影机包括停放未处理硅片或已处理硅片的上下料工位、承接经扫描/步进光刻机曝光的硅片的转移工位,以及进行硅片预处理、旋转涂胶、显影和清洗、去边、烘焙和冷却工艺的几个工位。
曝光
曝光是将光刻投影系统形成的强度分布转换为光刻胶中感光材料化学性质的变化。光子能量的大小决定了入射光能量向光刻胶中转移的物理机制。光刻胶吸收的光子能量如果与其价带能级或外层电子激发能量匹配,即可引发光化学反应。大多数深紫外光学光刻都采用了这种光化学反应,即光刻胶敏化机制。Dill模型描述了光学曝光时光刻胶化学性质的变化。该模型包括两个方程:

第一个方程是从朗伯-比尔定律推导而来,描述了光在光刻胶内传播时被化学组分吸收的过程。α是含光敏成分(PAC)或者光敏成分的相对浓度为[PAC]的光刻胶的吸收系数,它包括可漂白(光敏)成分吸收部分和不可漂白成分吸收部分。将未曝光状态下的光敏成分浓度归一化为1,则未曝光区域或未漂白区域的吸收系数为A(Dill)+B(Dill)。在充分曝光的区域,PAC的浓度为0,光刻胶吸收系数为B(Dill)。上面第二个公式描述了PAC的一级动力学过程与入射光光强I的关系。光敏度C(Dill)是光刻胶的另一个基本材料参数。根据光刻胶类型的不同,PAC可以是DNQ敏化剂、光酸生成剂(PAG),也可以是其他光敏化学成分。现代化学放大光刻胶也可能包含一定量的光漂白猝灭剂。有些光刻胶材料供应商会提供这些与波长有关的Dill材料参数。Dill模型及上述三个材料参数较好地描述了大多数现代光刻胶的光学响应特性。在厚胶情况下,入射光与光刻胶之间的相互作用长度增加,还需要考虑曝光过程中的光致折射率变化。特殊的光学材料和曝光技术(例如双光子吸收光刻)还需要考虑高阶动力学项。Dill方程中光强和PAC的分布通常是位置(x,y,z)与时间t的函数。因此上面两个方程是互相耦合的。PAC浓度的变化导致吸收率α(x,y,z,)空间分布的变化,进而引起光强分布I(x,y,z,t)发生改变。需要通过迭代方法求解Dill方程,而且每次迭代都需要重新计算体像,因此方程的求解非常耗时。标量离焦模型能够将光强和PAC的变化在横向(x,y)和轴向(z)解耦,可以在实现合理精度的同时高效地对中小NA(≤0.7)投影光刻系统中具有漂白行为的光刻胶曝光过程进行建模。应用于193nm/248nm 波长的高NA光刻中的大多数化学放大光刻胶都没有漂白行为。这种情况下A(Dill)接近于0,上式可以直接积分为: ,式中,
,式中, 和D分别是曝光时间和曝光剂量。
和D分别是曝光时间和曝光剂量。
光向光刻胶耦合的效率高低取决于硅片膜层的材料与结构。对不同厚度的光刻胶进行曝光,曝光后PAC的浓度以及显影后光刻胶形貌的仿真结果如下图所示

硅基底对曝光波长的折射率和消光系数很高,导致了强反射和明显的驻波,驻波干涉图与透光空图形的空间像叠加在一起。叠加后形成的光强分布被转换为PAC浓度分布,如图第一行所示。颜色较暗的区域表示PAC浓度降低。驻波图形中极小值点的数量随光刻胶厚度的增加而增加。图中第二行的光刻胶形貌剖面图反映了光刻胶内的干涉现象带来的两个重要后果。驻波的强度分布被转移到具有周期性波纹形貌的侧壁上。耦合到光刻胶中的能量随光刻胶厚度周期性地变化。对于430nm和530nm厚的光刻胶,来自光刻胶表面的背反射光与来自光刻胶/硅片界面的反射光发生相长干涉。相长干涉增加了硅片膜层的反射光总量。反射光的增加降低了光刻胶内部的光强,从而使光刻胶中形成的空图形变窄。光刻胶厚度介于两者之间时,来自光刻胶表面和光刻胶/硅片界面的反射光会发生相消干涉,导致反射光减少,光刻胶内部的强度增加。因此,光刻胶剖面图上的开口略微变宽。在下图所示的CD摆动曲线中也可以观察到光刻胶厚度对光刻图形尺寸的影响,非常明显。

CD随着光刻胶厚度的变化以及光刻胶侧壁的波纹状形貌都会对工艺的稳定性产生负面影响。影响的大小取决于光刻胶内向上和向下传播的光形成的干涉图的幅度。可以用摆动比例S表征相应的驻波图形。S的解析表达式为:

式中,R(top)、R(bot)分别是光在光刻胶上下表面的反射率;α是光刻胶的吸收系数;d是光刻胶厚度。根据上式可以采用如下策略减轻驻波效应及其对工艺稳定性的影响:
1、降低R(bot):在基底和光刻胶之间增加底部抗反射层(BARC)可减弱底部反射光,是最有效的摆动效应(驻波效应)抑制方法。上图中的曲线也表明采用了150nm厚的底部抗反射层后,CD变化量明显减少。BARC增加了工艺的复杂性。工艺设计阶段需要考虑BARC的刻蚀性能,以及它与光刻胶和基底的兼容性。在际应用中,至少需要增加BARC沉积和BARC清除等两个工艺步骤。
2、降低R(top):顶部抗反射层(TARC)位于光刻胶上表面,可降低顶部的反射。虽然TARC的抗反射效果没有BARC好,但TARC容易实施,不需要TARC清除工艺。
3、增加α:通过染色增加光刻胶的吸收率是另外一种相对有效的摆动效应抑制方法。该方法虽然非常容易实施,但会降低光刻胶的灵敏度、曝光剂量和焦深。
一般仅在垂直入射条件下对底部和顶部抗反射层进行优化。但是这种做法不适用于高NA光刻。因为高NA光刻中,照射到光刻胶的平面波的入射角范围较大。非平面硅片上BARC和光刻胶厚度的变化对反射率控制提出了更多约束。在铜、多晶硅、钨硅化物和铝硅等高反射基底上涂覆两层底部抗反射层,反射率可以低于2%。不能用薄膜领域的标准方法对非平面硅片上BARC的性能进行建模,需要对硅片面进行严格电磁场仿真。
化学显影
光刻胶的溶解速度取决于局部脱保护位点的浓度[M],显影速率r与[M]之间的显影模型:

式中,r(min)和r(max)分别是完全被保护的光刻胶和脱保护的光刻胶的显影速率;M(th)是显影反应刚开始时的抑制剂或保护位点浓度阈值;参数N表征显影速率曲线的斜率或陡度大小,如下图所示

下图显示了不同时刻的光刻胶形貌仿真结果。第一行是没有BARC和扩散情况下的仿真结果。PAC的浓度呈现出明显的驻波现象。随着显影的进行,界面的演化大部分发生在驻波图形的暗节点上,这些位置的PAC/抑制剂浓度很高,显影速率较低。90s之后显影液还没有到达光刻胶底部。应用BARC或者扩散长度较大的光刻胶都可以减弱驻波。显影液渗透的速度快很多,通常不到1s或几秒就能到达光刻胶的底部,如下图的第二行所示。实践中,为实现良好的工艺稳定性,通常将显影时间设置在30~ 90s。

陡度参数N对光刻胶形貌的影响如下图所示。仿真中对曝光剂量都进行了调整,使得显影后光刻胶底部CD相同。N较小时,光刻胶侧壁倾斜得非常明显。随着N不断增大,光刻胶的行为更像一个阈值检测器,能够产生竖直的侧壁。大多数光刻应用都需要陡峭的侧壁,需要采用N值较大的光刻胶。N值较小的光刻胶有利于产生表面变化连续的形貌,适用于灰度光刻。
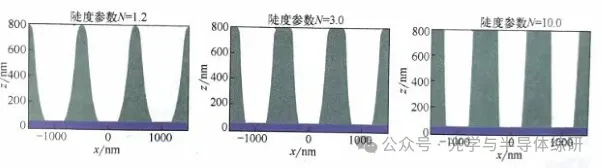
建模
通过对光刻胶的物理化学现象进行半经验抽象建模得到了上述光刻胶建模方法。这些方法利用理想的光刻胶模型和相应数学方程描述CAR光刻胶(以及DNQ型光刻胶)的基本反应机制和现象。将这些模型应用于不同的场景,可定性或定量地研究脱保护动力学、扩散效应和猝灭剂负载对光刻性能的影响。仿真结果是对实验数据和专业知识的有益补充,有助于新型光刻胶材料和工艺的开发。然而上述模型不能完整地反映光刻胶的分子组分以及它们与显影液相互作用的所有细节,难以高精度地测出动力学反应常数和扩散系数等模型参数,而且这些参数还受工艺条件的影响。发生在光刻胶顶部和底部界面的有关效应越来越重要,需要利用数学公式设置合适的边界条件,这些都增加了模型参数的数量和计算复杂度。标定含有许多未知参数的光刻胶模型需要用到大量的实验数据。需要特别注意一些共性可移植的参数,标定结果须可以方便地适用于其他成像和工艺条件。在特征尺寸小于100nm的情况下,不能再将光刻胶视为组分分布连续的材料,即光酸浓度、猝灭剂和保护位点浓度都是空间上连续、平滑的物理量。本文接下来介绍几种软件中常用的紧凑型光刻胶模型。这些模型可以描述一些重要的光刻胶效应,常用于光学邻近效应修正(OPC)以及光刻掩模和光学系统新技术研发。这些紧凑模型形式非常简单,只需几个参数就可以描述光刻胶,计算量小、速度快,在其应用范围内,计算精度也足够。
最简单的光刻胶建模方法是阈值模型。该模型采用光强阈值I(THR)描述光刻胶。正性光刻胶中成像光强I 高于阈值的区域将被显影掉,其余区域保持不变。因此,可以采用阶跃函数描述归一化的光刻胶高度:

光阈值I(THR)取决于光刻胶、工艺条件和归一成像光强,典型值介于0.2与0.4之间。阶跃函数在光强阈值I(THR)处的跳变会导致OPC等计算光刻技术中常用的优化算法产生数值问题,因此,常用含一个参数a的S型函数代替阶跃函数。a表征了完全显影光刻胶和完全未溶解光刻胶之间的过渡区域的陡度或锐利度:

下图比较了阶跃函数以及参数a不同的两个S型函数。阶跃函数可以被看作是具有无限大陡度的S型函数,a→∞。

阈值模型并不能准确近似真实光刻胶工艺。为了准确地预测CD,需要根据工艺、掩模图形和周期调整阈值的大小。模型误差也会随着光刻胶厚度的增大以及图像对比度的降低而增大。可以在阈值模型中加人了一个校正项。该校正项与光刻胶厚度、光刻胶对比度以及像对数斜率有关。变阈值光刻胶模型(VTRM)可有效克服常数值模型的不足。这类模型都假设阈值是成像强度最大值、斜率等成像参数的函数。通常,可将VTRM看作是以像和工艺参数为变量的响应面模型。利用适当的实验数据可拟合出模型参数。其他紧凑型模型利用不同的数学运算处理空间像或者体像,使处理之后的像与光刻胶轮廓相似。这些数学运算需要能够基于物理机制仿真出典型的光刻胶效应。为了最大程度地缩短计算时间,这类模型需要具备较高的计算效率。最简单的形式就是利用空间像的卷积来仿真光刻胶特定组分的扩散导致的对比度损失。高级模型可以采用数学运算仿真耦合在一起的扩散/动力学效应与中和反应。下图为RoadRunner模型将体像转变为光刻胶形貌的过程。仿真中采用了一个简单的线空图形。

从体像开始建模,体像即光刻胶中的光强分布。建模步骤如下:
1、根据Dill方程计算光刻胶内酸的潜像,对于非漂白光刻胶: ,这里C(Dill)代表光刻胶的灵敏度,D是曝光剂量,I(x,z)是体像。
,这里C(Dill)代表光刻胶的灵敏度,D是曝光剂量,I(x,z)是体像。
2、在光刻胶高度z方向上对潜(酸)像进行平均: 。在这一步中,可以利用高斯或线性加权函数突出某z向位置上的潜(酸)像,形成压缩潜像。压缩潜像仅与横向坐标x有关,降低了后续步骤的计算量。
。在这一步中,可以利用高斯或线性加权函数突出某z向位置上的潜(酸)像,形成压缩潜像。压缩潜像仅与横向坐标x有关,降低了后续步骤的计算量。
3、在第一个中和反应步骤中,压缩潜(酸)像 与负载分布均匀的猝灭剂Q(0)之间的反应可表示为:
与负载分布均匀的猝灭剂Q(0)之间的反应可表示为:

上式中的取最大值运算保证了酸和碱的浓度(相减之后)不为负数。
4、酸和猝灭剂(碱)各自发生扩散,分别用卷积高斯核进行建模。卷积核的关键参数为酸和碱的(有效)扩散长度:

5、将步骤3所示的模型应用于扩散后的酸与猝灭剂,对第二个中和反应进行建模:

6、利用步骤5中得到的酸浓度 计算催化脱保护反应之后脱保护位点或抑制剂的有效浓度。会用到酸催化脱保护反应的放大系数和后烘时间:
计算催化脱保护反应之后脱保护位点或抑制剂的有效浓度。会用到酸催化脱保护反应的放大系数和后烘时间:

7、将上文提到的显影速率模型应用到 ,可以得到上图中所示的局部速率。
,可以得到上图中所示的局部速率。
8、假设显影仅发生在竖直方向,利用之前步骤中计算出的显影速率(为常数),计算出显影一段时间后剩余的光刻胶厚度。
可以很方便地将RoadRunner模型扩展应用到接触孔阵列或有限长线条等三维图形。该模型易于实现且计算时间短。校准后,DUV和EUV工艺模型可以预测不同周期、离焦和曝光剂量情况下的实测CD值,仿真精度约为1nm。由于RoadRunner 模型只沿z轴进行平均计算,忽略了横向的显影,因此不能准确地预测三维光刻胶形貌的侧壁角。考虑到三维光刻胶效应的重要性,最新的三维紧凑型光刻胶模型利用光刻胶内多个水平面上计算的像进行建模。这类模型包括了z向扩散效应,以及光刻胶顶部与底部各自的边界效应。
总结
典型的光刻工艺步骤包括硅片表面清洗、旋转涂胶、前烘、曝光、曝光后烘焙(PEB)与显影。光与光刻胶的相互作用可采用Dill模型进行描述。光刻胶下方材料对光的反射也会影响曝光结果。这种反射会引起驻波、侧壁波纹,以及特征尺寸或CD随光刻胶厚度发生周期性变化。添加底部抗反射涂层,可以减弱反射带来的影响。PEB过程中化学物质的扩散也可以减少驻波效应。可以利用与材料有关的显影速率曲线表征光刻胶的显影行为。显影速率模型可以产生显影速率曲线。
来源:旺材芯片

半导体工程师
半导体经验分享,半导体成果交流,半导体信息发布。半导体行业动态,半导体从业者职业规划,芯片工程师成长历程。
